
KRi ���l�x��Դ RFICP 40
�Ϻ����|��������ԭ�b�M�� KRI ���l�x��Դ RFICP 40 : Ŀǰ KRI ���l�x��Դ RFICP ϵ�гߴ�С, �ͳɱ���Ч�x��Դ. �m���ڼ�����С�͵����ǻ�w��. �x��Դ RFICP 40 �OӋ���Ä��µĖŘO���g�����аl���_�l����. �x��Դ RFICP 40 �o����x���z�OӋ, �m����ͨ����w�ǻ��Ԛ��w�r�Ĺ��I����. �˜������� RFICP 40 �x���������� 100 �� 1200ev, �x��������Գ��^ 120 mA.
���l�x��Դ RFICP 40 ����:
1. �x��Դ���ǻ Discharge Chamber, �o����x���z, ͨ�^���l���g�ṩ���ܶ��x��, ��ˇ�r�g���L.
2. �x��Դ�Y��ģ�K���OӋ, ʹ�ø�����; �������{��, �����g���ʺ;�����.
3. �ṩ�۽�, �lɢ, ƽ�е��x����
4. �x��Դ�Ԅ��{�����g���ϖŘO��ʹ�É����Ϳ��؏͵Ĺ�ˇ�\��
5. �ŘO���|�f��ʯī,�Թ�����
6. �x��Դ�к��� Neutralizer, �y���Ϳ�����Ӱl��,�_��늺�����
KRI ���l�x��Դ RFICP 40 ���g����:
��̖ | RFICP 40 |
Discharge ꖘO | RF ���l |
�x������ | >100 mA |
�x�ӄ��� | 100-1200 V |
�ŘOֱ�� | 4 cm �� |
�x���� | �۽�, ƽ��, ɢ�� |
���� | 3-10 sccm |
ͨ�� | Ar, Kr, Xe, O2, N2, H2, ���� |
���͉��� | < 0.5m Torr |
�L�� | 12.7 cm |
ֱ�� | 13.5 cm |
��� | LFN 2000 |
KRi ���l�x��Դ���͑��ã�
�A��ϴ PC
�������
�o���Ĥ (��W�Ĥ ) IBAD
�R僺����l�Ĥ PC
�x�ӞR����e�Ͷ��ӽY�� IBSD
�x���g�� IBE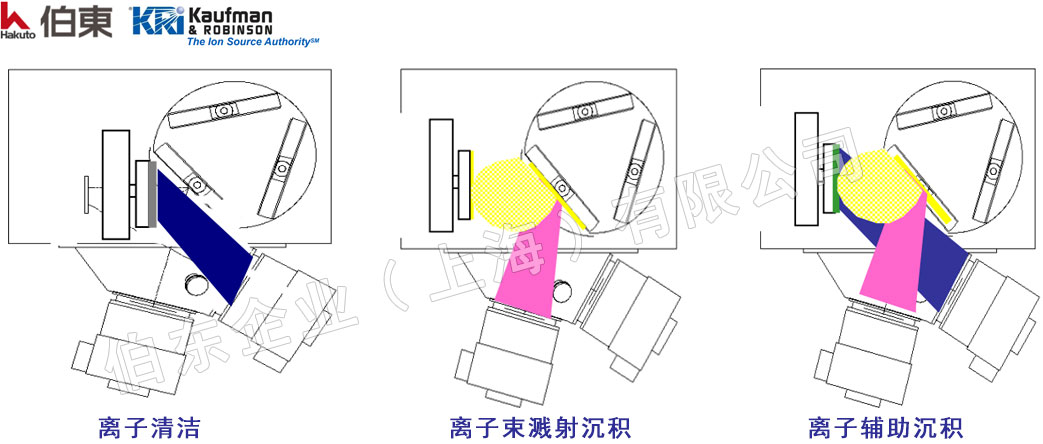
KRi ���l�x��Դ RFICP 40 �͑�������
���b�� e-beam ��������lϵ�y, �M�� IBAD �o���Ĥ (������僷���Ϳ��).
1978 �� Dr. Kaufman ��ʿ���������� Kaufman & Robinson, Inc ��˾, �аl���a�����x��Դ, �����OӋԭ���֞鿼�����x��Դ, �����x��Դ�����l�x��Դ. �����������x��Դ�v�� 40 ��������lչ��ȡ�ö�헌���. �x��Դ�V�������x����ϴ PC, �x���g�� IBE, �o���Ĥ IBAD, �x�ӞR���Ĥ IBSD �I��, �Ϻ����|������ KRi �������x��Դ�Ї�������.
T: +86-21-5046-1322 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 152-0195-1076 M: +886-939-653-958
www.hakuto-china.cn www.hakuto-vacuum.com.tw


